精选案例 | 键合线测量
引线键合(Wire Bonding)是使用金线、银线或铜线等金属线,将半导体裸芯片(Die)焊区与封装基板上的金属布线焊区连接,并利用热能、超声波能量和压力使得金属线两端与焊区紧密焊合,从而实现封装芯片的电气连接。虽然引线键合工艺是在20世纪50年代发展起来,但因其较低的成本和高可靠性,在当今市场上仍有75%至80%的封装类型采用该工艺,例如闪存和某些新型的传感器。
在一个典型引线键合工艺流程中,首先将裸芯片附着在基板上。然后使用引线键合机金属线送入细管中。通过加热使得金属线的末端形成一个球状,并利用超声波能量或者压力将焊球焊接至焊区。然后系统提升细管,并定位至引线框焊区,使用相同工艺完成金属线尾端与引线框焊区焊接。系统切断并提升系统细管后,一条金属线的引线键合工艺完成。
键合工艺完成后,需要借助光学检测技术确认金属引线的键合效果,包括线高、线共面度和焊接缺陷等。键合线的测量需面对金属线反光,线细(通常为20-40微米),以及测量精度要求高等挑战。
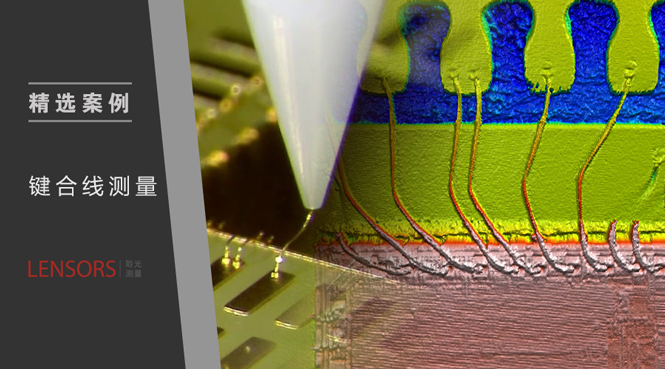
一、测量需求
1.键合线高与共面度
2.键合线焊接缺陷
二、测量步骤
1.固定样品至FocalStation测量台,并进行机械原点归位;
2.在FS软件中设置扫描参数,开始扫描并等待任务完成;
3.数据预处理,包含校平、光学降噪等;
4.分析与报告;
三、焊接缺陷
利用3D视图对测量点云数据进行显示,可以直接查看键合线首尾部位的焊接效果,判断是否存在焊接缺陷。同时,还可以旋转视图查看键合线的整体状态,判断是否存在乱线、断线等缺陷。

图1. 3D视图查看键合线焊接缺陷

图2.键合线3D视图
四、线高与共面度
利用2D截面和台阶分析工具,可以对键合线的线高进行分析,并整体评价键合线的共面度。测量结果可反馈工艺部门,供键合工艺参数调整。

图3. 键合线高和共面度计算
欢迎关注官方微信


